D'Beschichtungsmethoden vum Photoresist sinn allgemeng a Spinbeschichtung, Dipbeschichtung a Rollbeschichtung opgedeelt, dorënner Spinbeschichtung am meeschte benotzt. Duerch Spinbeschichtung gëtt Photoresist op de Substrat getrëppelt, an de Substrat kann mat héijer Geschwindegkeet rotéiert ginn fir e Photoresistfilm ze kréien. Duerno kann e festen Film kritt ginn andeems en op enger waarmer Plack erhëtzt gëtt. Spinbeschichtung ass gëeegent fir d'Beschichtung vun ultra-dënnen Filmer (ongeféier 20nm) bis décke Filmer vun ongeféier 100um. Seng Charakteristiken sinn gutt Uniformitéit, eenheetlech Film deck tëscht wafers, puer Mängel, etc., an engem Film mat héich Beschichtung Leeschtung kann kritt ginn.
Spin Coating Prozess
Wärend der Spinbeschichtung bestëmmt d'Haaptrotatiounsgeschwindegkeet vum Substrat d'Filmdicke vum Photoresist. D'Relatioun tëscht der Rotatiounsgeschwindegkeet an der Filmdicke ass wéi follegt:
Spin = kTn
An der Formel ass Spin d'Rotatiounsgeschwindegkeet; T ass d'Filmdicke; k an n sinn Konstanten.
Faktoren déi de Spinbeschichtungsprozess beaflossen
Och wann d'Filmdicke vun der Haaptrotatiounsgeschwindegkeet bestëmmt gëtt, ass et och mat Raumtemperatur, Fiichtegkeet, Photoresistviskositéit a Photoresisttyp verbonnen. Verglach vu verschiddenen Zorte vu photoresist Beschichtungskurven gëtt an der Figur 1 gewisen.
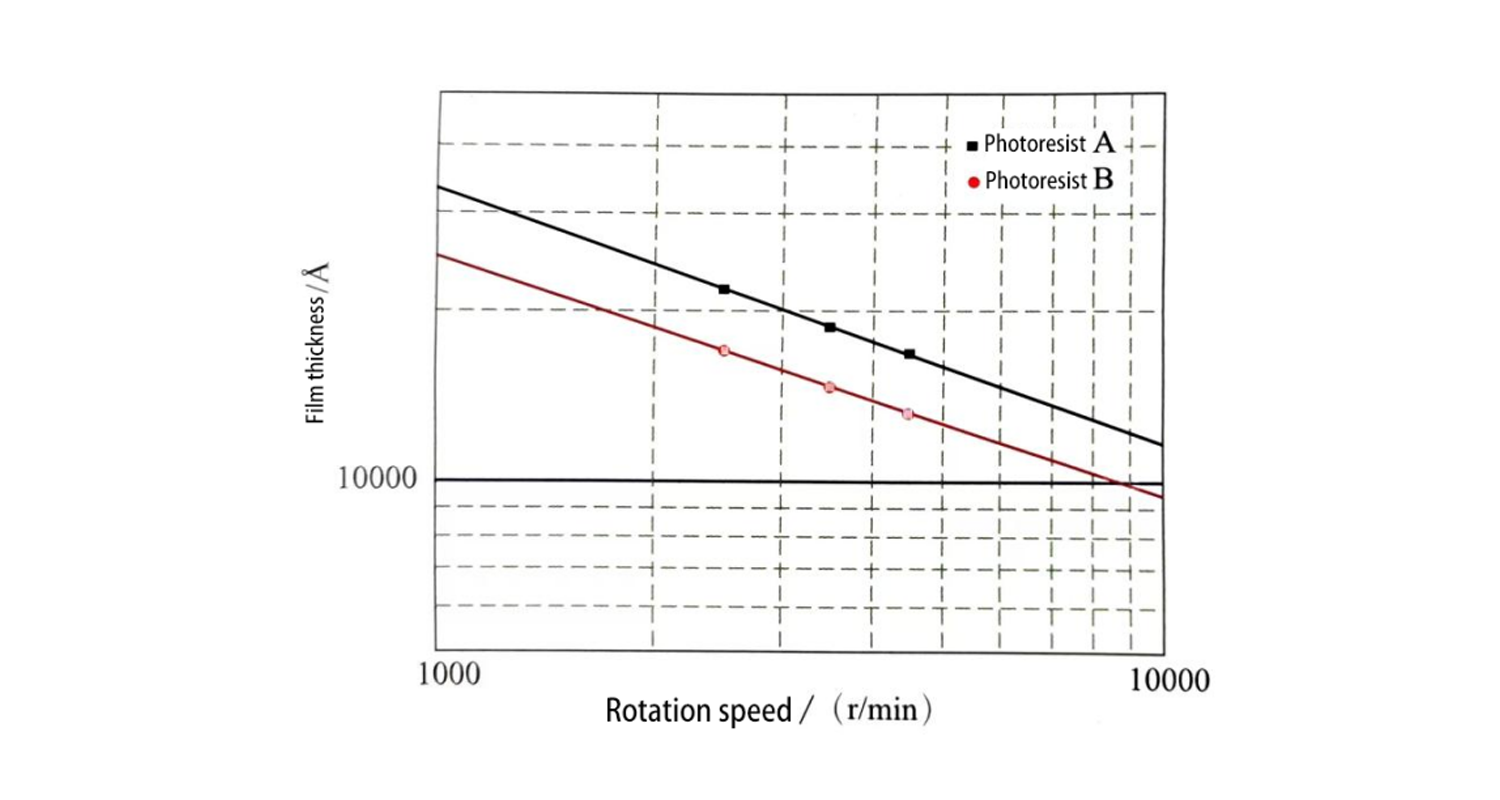
Figur 1: Verglach vun verschidden Zorte vu photoresist Beschichtungskurven
Den Afloss vun Haaptrotatioun Zäit
Wat méi kuerz d'Haaptrotatiounszäit ass, dest méi déck ass d'Filmdicke. Wann d'Haaptrotatiounszäit erhéicht gëtt, dest méi dënn gëtt de Film. Wann et méi wéi 20s ass, bleift d'Filmdicke bal onverännert. Dofir gëtt d'Haaptrotatiounszäit normalerweis méi wéi 20 Sekonnen ausgewielt. D'Relatioun tëscht der Haaptrotatiounszäit an der Filmdicke gëtt an der Figur 2 gewisen.

Figur 2: Relatioun tëscht Haaptrei Zäit an Film deck
Wann de Photoresist op de Substrat getrëppelt gëtt, och wann déi spéider Haaptrotatiounsgeschwindegkeet d'selwecht ass, wäert d'Rotatiounsgeschwindegkeet vum Substrat wärend dem Drëps d'endgülteg Filmdicke beaflossen. D'Dicke vum Photoresistfilm erhéicht mat der Erhéijung vun der Substratrotatiounsgeschwindegkeet während dem Drëpsen, wat wéinst dem Afloss vun der Léisungsmëttelverdampfung ass, wann de Photoresist nom Drëpsen ausklappt. Figur 3 weist d'Relatioun tëscht der Filmdicke an der Haaptrotatiounsgeschwindegkeet bei verschiddene Substratrotatiounsgeschwindegkeet wärend der Photoresist Drëpsen. Et kann aus der Figur gesi ginn datt mat der Erhéijung vun der Rotatiounsgeschwindegkeet vum Drëpsen Substrat d'Filmdicke méi séier ännert, an den Ënnerscheed ass méi offensichtlech an der Géigend mat enger niddereger Haaptrotatiounsgeschwindegkeet.

Figur 3: Relatioun tëscht Filmdicke an Haaptrotatiounsgeschwindegkeet bei verschiddene Substratrotatiounsgeschwindegkeet wärend der Photoresist Dispensing
Effekt vun der Fiichtegkeet während der Beschichtung
Wann d'Feuchtigkeit erofgeet, erhéicht d'Filmdicke, well d'Feuchtigkeit Ofsenkung d'Verdampfung vum Léisungsmëttel fördert. Wéi och ëmmer, d'Filmdicke Verdeelung ännert sech net wesentlech. Figur 4 weist d'Relatioun tëscht Fiichtegkeet a Filmdicke Verdeelung während Beschichtung.

Figur 4: Relatioun tëscht Fiichtegkeet a Filmdicke Verdeelung während Beschichtung
Effekt vun der Temperatur während der Beschichtung
Wann d'Indoor Temperatur eropgeet, erhéicht d'Filmdicke. Et kann aus der Figur 5 gesi ginn datt d'Fotoresist Filmdicke Verdeelung vu konvex op konkav ännert. D'Kurve an der Figur weist och datt déi héchst Uniformitéit kritt gëtt wann d'Indoortemperatur 26 ° C ass an d'Fotoresisttemperatur 21 ° C ass.

Figur 5: Relatioun tëscht Temperatur an Film deck Verdeelung während Beschichtung
Effekt vun der Auspuffgeschwindegkeet während der Beschichtung
Figure 6 weist d'Relatioun tëscht Auspuffgeschwindegkeet a Filmdicke Verdeelung. Beim Fehlen vun Auspuff weist et datt den Zentrum vun der Wafer éischter verdicken. D'Erhéijung vun der Auspuffgeschwindegkeet wäert d'Uniformitéit verbesseren, awer wann et ze vill erhéicht gëtt, wäert d'Uniformitéit erofgoen. Et kann gesi ginn datt et en optimale Wäert fir d'Auspuffgeschwindegkeet ass.

Figur 6: Relatioun tëscht Auspuff Geschwindegkeet a Filmdicke Verdeelung
HMDS Behandlung
Fir de Photoresist méi coatable ze maachen, muss de Wafer mat Hexamethyldisilazan (HMDS) behandelt ginn. Besonnesch wann d'Feuchtigkeit un der Uewerfläch vum Si-Oxidfilm befestegt ass, gëtt Silanol geformt, wat d'Adhäsioun vum Photoresist reduzéiert. Fir d'Feuchtigkeit ze entfernen an d'Silanol ofzebauen, gëtt de Wafer normalerweis op 100-120 ° C erhëtzt, a Niwwel HMDS gëtt agefouert fir eng chemesch Reaktioun ze verursaachen. De Reaktiounsmechanismus gëtt an der Figur 7. Duerch HMDS-Behandlung gëtt d'hydrophil Uewerfläch mat engem klenge Kontaktwénkel eng hydrophobe Uewerfläch mat engem grousse Kontaktwinkel. Heizung vun der Wafer kann méi héich Photoresist Adhäsioun kréien.
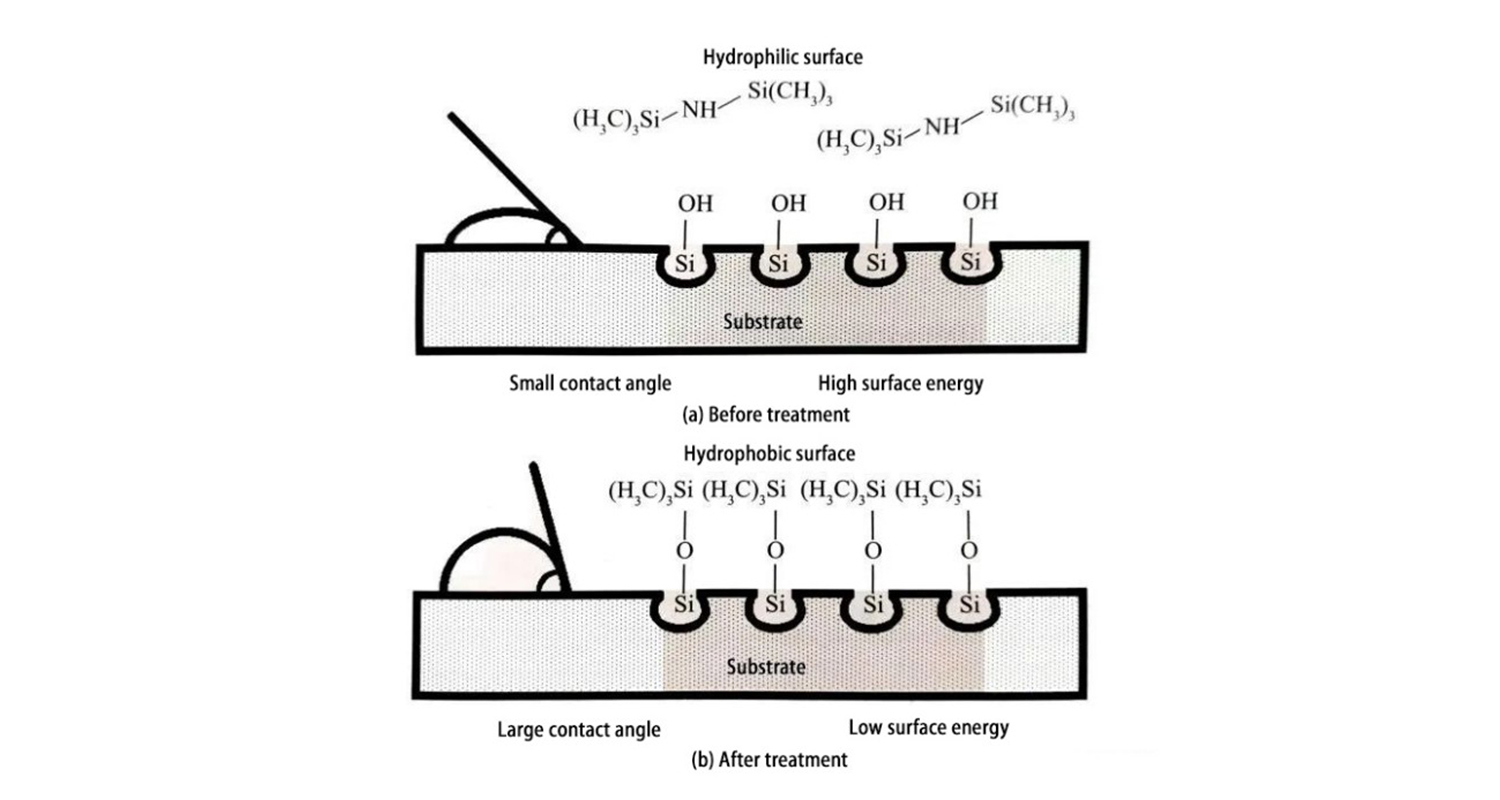
Figur 7: HMDS Reaktioun Mechanismus
Den Effekt vun der HMDS Behandlung kann observéiert ginn andeems de Kontaktwinkel gemooss gëtt. Figur 8 weist d'Relatioun tëscht HMDS Behandlung Zäit a Kontakt Wénkel (Behandlung Temperatur 110 ° C). De Substrat ass Si, d'HMDS Behandlungszäit ass méi wéi 1min, de Kontaktwénkel ass méi wéi 80 °, an de Behandlungseffekt ass stabil. Figur 9 weist d'Relatioun tëscht HMDS Behandlung Temperatur a Kontakt Wénkel (Behandlung Zäit 60s). Wann d'Temperatur méi wéi 120 ℃ ass, fällt de Kontaktwénkel erof, wat beweist datt HMDS duerch Hëtzt zerfällt. Dofir gëtt HMDS Behandlung normalerweis bei 100-110 ℃ gemaach.
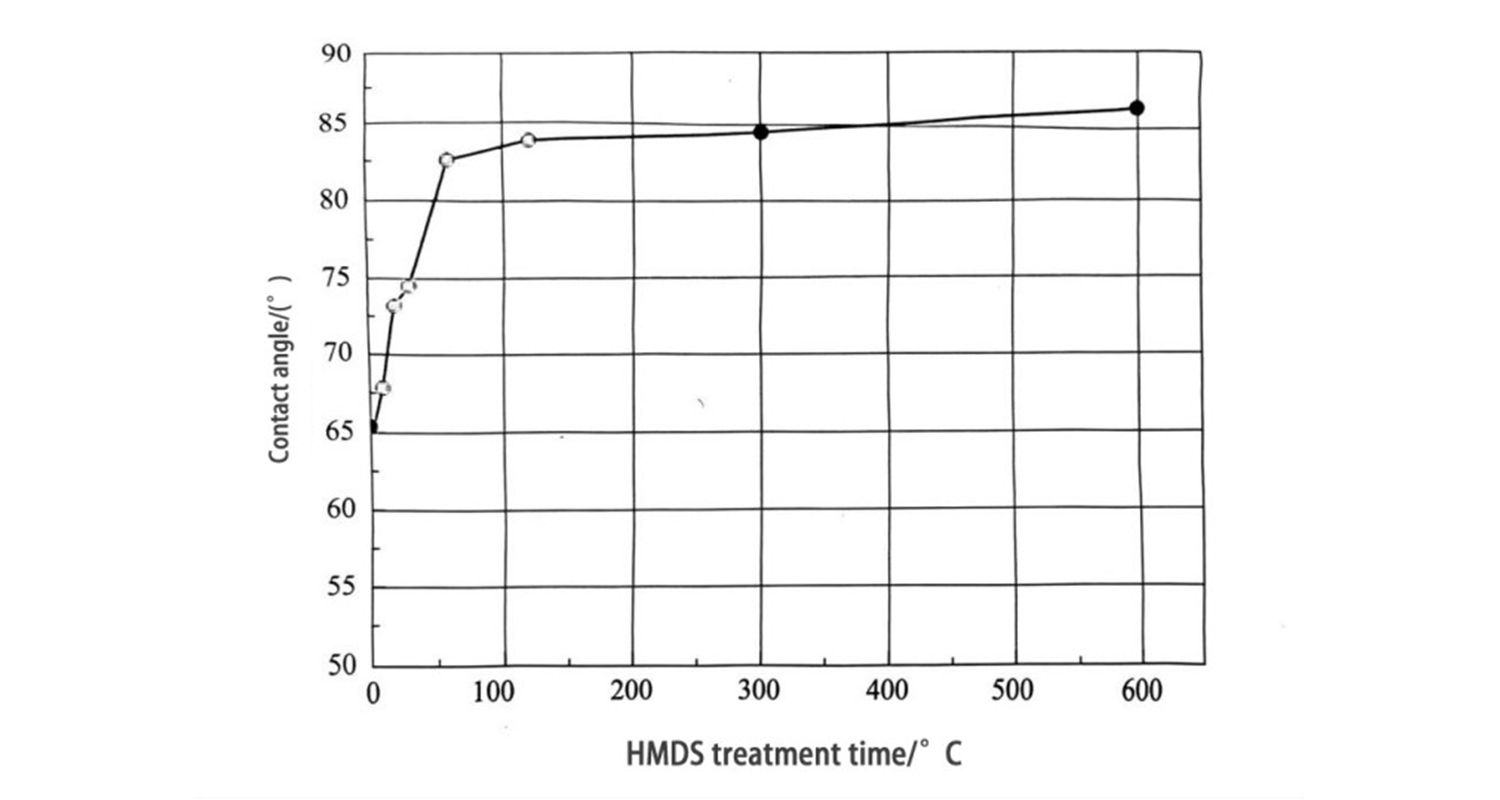
Figur 8: Relatioun tëscht HMDS Behandlung Zäit
a Kontaktwénkel (Behandlungstemperatur 110 ℃)

Figur 9: Relatioun tëscht HMDS Behandlung Temperatur a Kontakt Wénkel (Behandlung Zäit 60s)
HMDS Behandlung gëtt op engem Siliziumsubstrat mat engem Oxidfilm ausgefouert fir e Photoresist Muster ze bilden. Den Oxidfilm gëtt dann mat Fluorsäure mat engem Puffer derbäi ätzt, an et gëtt festgestallt datt no der HMDS-Behandlung de Photoresist-Muster net ofgefall ka ginn. Figur 10 weist den Effet vun HMDS Behandlung (Muster Gréisst ass 1um).
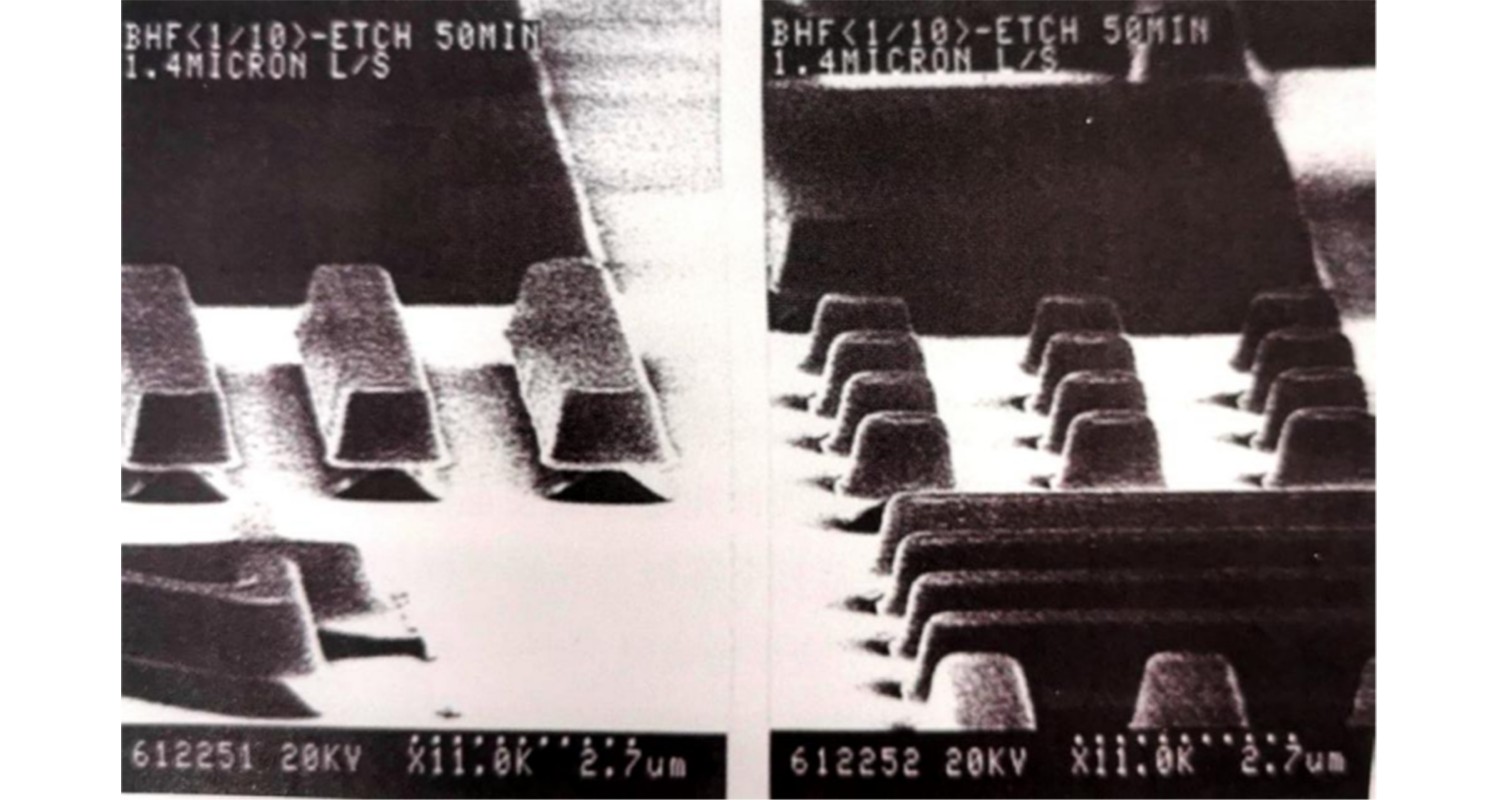
Figur 10: HMDS Behandlungseffekt (Mustergréisst ass 1um)
Prebaken
Bei der selwechter Rotatiounsgeschwindegkeet, wat méi héich d'Virbaktemperatur ass, wat d'Filmdicke méi kleng ass, wat beweist datt wat méi héich d'Virbaktemperatur ass, wat méi Léisungsmëttel verdampt, wat zu enger méi dënnter Filmdicke resultéiert. Figure 11 weist d'Relatioun tëscht der Pre-Backtemperatur an dem Dill's A Parameter. Den A Parameter weist d'Konzentratioun vum fotosensiblen Agent un. Wéi kann aus der Figur gesi ginn, wann d'Vir-Backtemperatur op iwwer 140 ° C eropgeet, fällt den A-Parameter erof, wat beweist datt de photosensitive Agent bei enger Temperatur méi héich wéi dëst zerstéiert. Figur 12 weist d'Spektraltransmittanz bei verschiddene Pre-Backtemperaturen. Bei 160°C an 180°C kann eng Erhéijung vun der Transmissioun am Wellelängteberäich vun 300-500nm observéiert ginn. Dëst bestätegt datt de photosensitive Agent bei héijen Temperaturen gebak an ofgebaut gëtt. D'Pre-Backtemperatur huet en optimale Wäert, deen duerch Liichtcharakteristiken a Sensibilitéit bestëmmt gëtt.
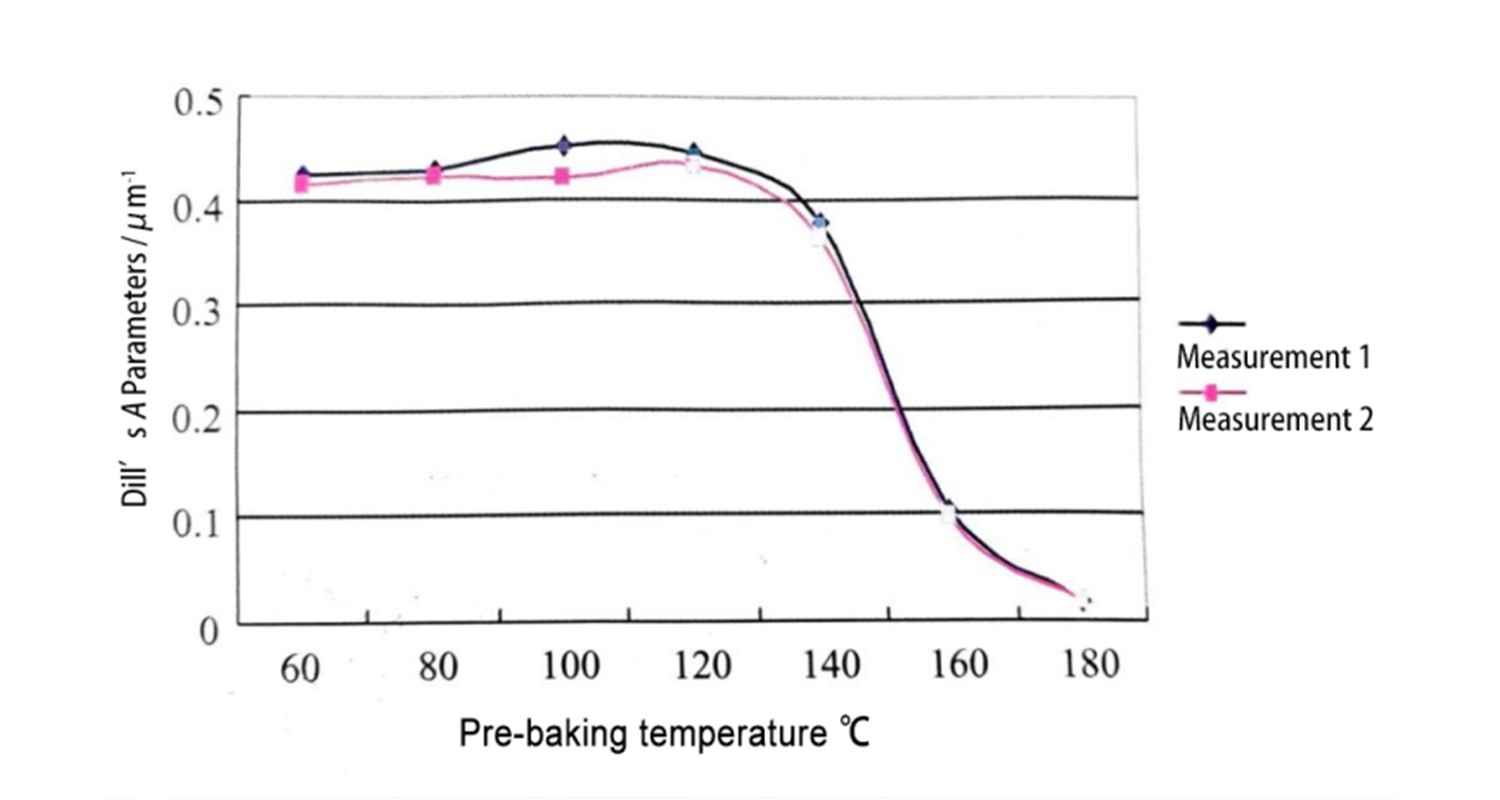
Figur 11: Relatioun tëscht Pre-baken Temperatur an Dill's A Parameter
(gemoossene Wäert vun OFPR-800/2)
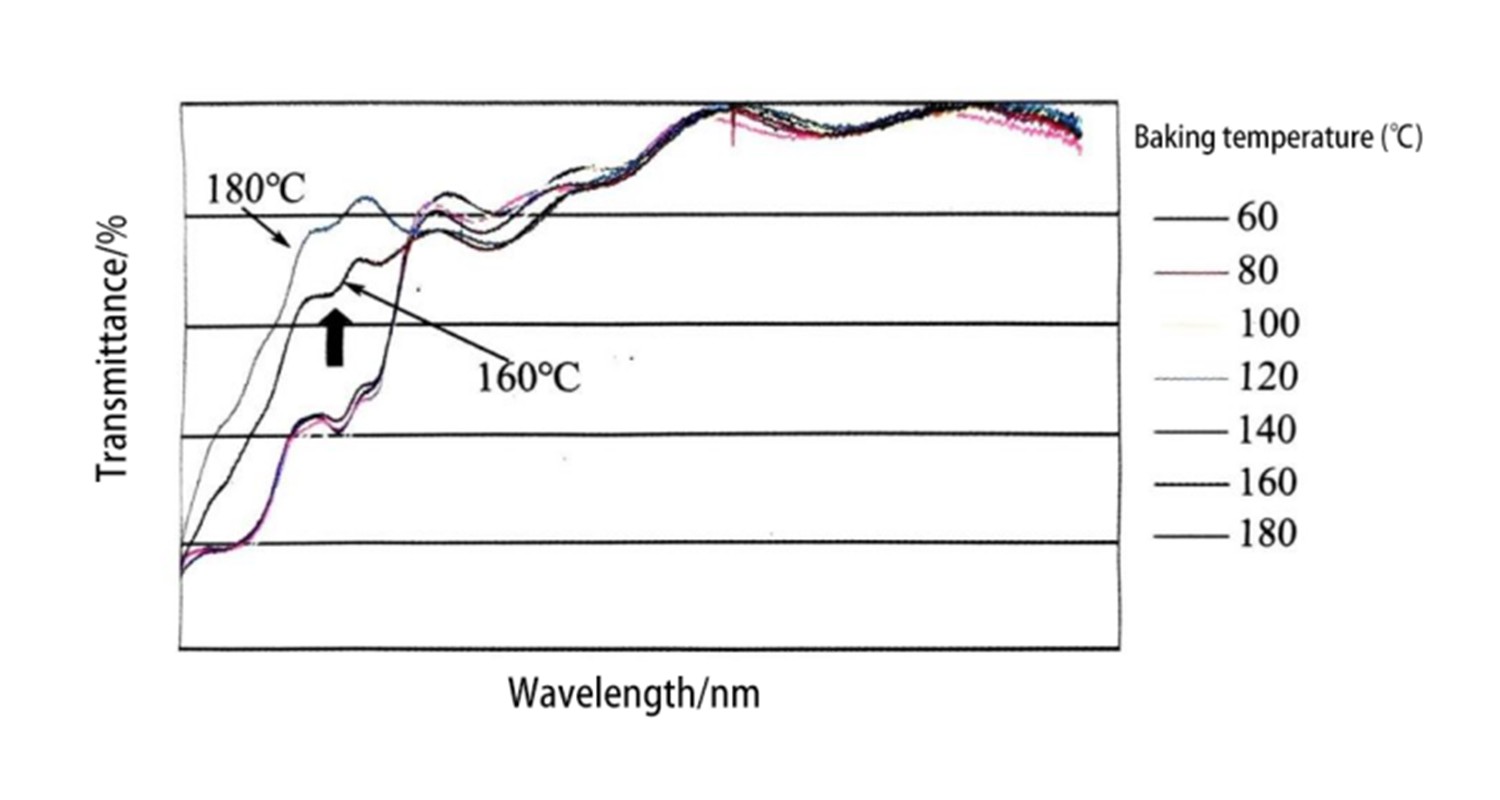
Figur 12: Spektraltransmittance bei verschiddene Pre-Backtemperaturen
(OFPR-800, 1um Filmdicke)
Kuerz gesot, d'Spinbeschichtungsmethod huet eenzegaarteg Virdeeler wéi präzis Kontroll vun der Filmdicke, héich Käschtenleistung, mëll Prozessbedéngungen an einfacher Operatioun, sou datt et bedeitend Effekter huet fir d'Verschmotzung ze reduzéieren, Energie ze spueren an d'Käschteleistung ze verbesseren. An de leschte Joeren huet d'Spinbeschichtung ëmmer méi Opmierksamkeet gewonnen, a seng Uwendung huet sech no an no op verschidde Felder verbreet.
Post Zäit: Nov-27-2024
